Xe プラズマ FIB-SEMシステム 【SOLARIS X 2】
TESCAN社の最新鋭SOLARIS X 2は、従来のGa FIB-SEMシステムでは困難だった材料解析のために製品化されたプラズマFIBと、イマージョン光学系を装備した超高分解能FE-SEMが一体となった分析システムです。
TSV(シリコン貫通電極)、MEMS、はんだバンプ、Cu ピラー、BGA の全体構造といった広いスケールの構造をもつ材料や深く埋もれた構造をもつ材料に対して、大面積の加工を高速で行うことが可能になることに加えて、クラス最高の低加速SEM観察能力により高い精度での物理解析が実現します。また、ToF-SIMS、ラマンといった分析技術とのマルチモーダルイメージングが可能です。
特長
- 最大1mm幅のFIB断面加工を高速で実現した最新型FIB-SEM
- Gaフリーでの微小試料作成
- カーテニング等のアーティファクトを抑制するRocking Stageなど、TESCAN社独自技術を複数搭載
- イマージョン光学系を装備した超高分解能SEM
- インカラム検出器による二次電子 / 反射電子検出
- TESCAN社の特許技術Static 3D-EBSDによる3次元の組織解析
- FIBを一次イオン源としたToF-SIMSを搭載可能
- 共焦点ラマン顕微鏡との融合が可能

XeプラズマFIBにより、650μm 幅で作製されたC4 バンプ、TSV(シリコン貫通電極)、マイクロバンプを含む断面

SMT コンデンサの 3次元再構築像を1000 x 250 x 500μm3 の領域で取得

はんだバンプで接合されたTSV(シリコン貫通電極) の EDS によるNi(緑)、Sn(赤)、Cu(黄)、合金相(青)の 3 次元再構築像

多くの形態観察、化学、物性分析が、SOLARIS X 2 1台で実行可能です。
テクノロジー
新型iFIB+™の特長

XeプラズマFIBを用いたTEM試料作製

ピエゾ駆動アパーチャ制御によるセミオートビーム調整

あらゆる方向にチルト可能な高精度ロッキングステージ
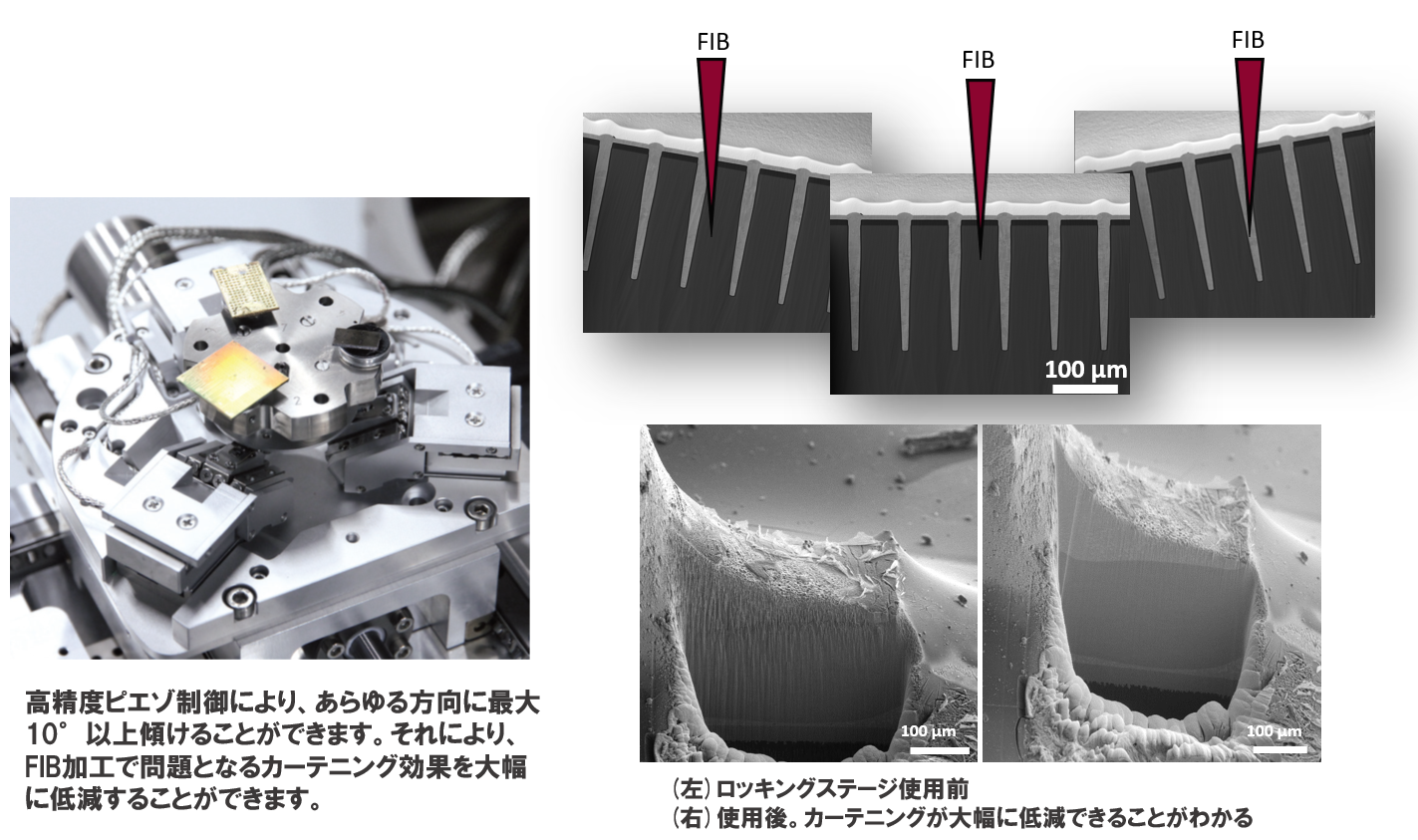
直感的ユーザーインターフェース/大型サンプルチャンバー

仕様
電子光学系
| 電子銃 | 高輝度ショットキーエミッタ |
|---|---|
| SEMカラム | トリプル対物レンズ搭載TriglavTMカラム |
| 分解能 | 標準モード 0.6nm at 15kV 1.2nm at 1kV ビーム減速モード 0.9nm at 1kV STEM 0.5nm at 30kV |
| 最大観察視野 | 10mm at Max WD |
| 加速電圧 | 50V ~ 30kV |
| 最大プローブ電流 | 400nA |
イオン光学系
| FIBカラム | i-FIB + |
|---|---|
| イオン銃 | Xe プラズマ FIB (ECRタイプ) |
| 分解能 | < 12nm at 30kV |
| 加速電圧 | 3kV ~ 30kV |
| プローブ電流 | 1pA ~ 3μA |
| SEM-FIB コインシデンス | WDSEM = 5mm |
Xe FIBのメリット
加工面積 (時間)
XeプラズマFIBは、Ga FIBに比較して50倍以上のミリングレートを実現します。
従来数10μmと限定されていた加工範囲が100μmを上回り、最大1mmの加工が実現しました。
またTESCAN社の独自技術であるフィールドフリーUHR SEMカラムの搭載により、
大容量3次元トモグラフィー像が高い空間分解能で取得可能です。
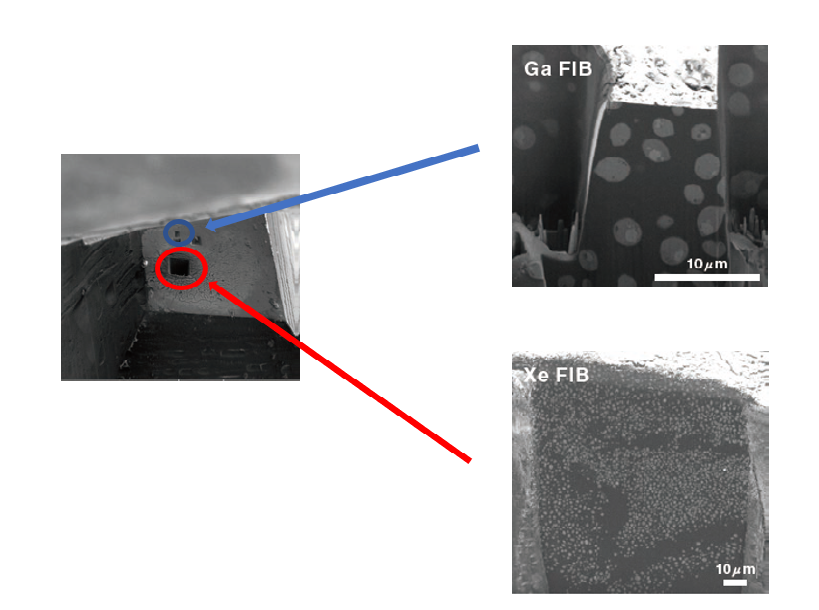
樹脂包理された酵母菌に対し、Ga FIBとXe FIBでそれぞれ15分加工したデータ
- 右上 Ga FIBにより加工された断面像
- 右下 Xe FIBにより加工された断面像
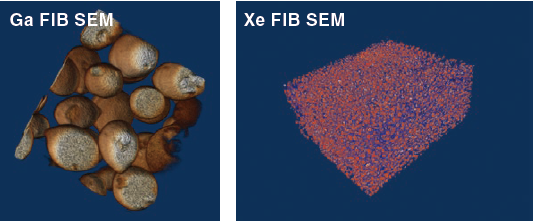
樹脂包理された酵母菌の3次元再構築像
- 左 Ga FIB 10 x 10 x 10μm Voxelサイズ15nm
- 右 Xe FIB 140 x 100 x 65μm Voxelサイズ100nm
微小試料作成および化学分析時におけるコンタミネーション
Xeイオンは化学的・電気的に不活性であるため、イオン入射による金属化合物の形成/偏析や汚染が起こりません。
従って材料が持つ物理特性の変化や、SEM-EDSやFIB-SIMSにおける化学分析時のスペクトル干渉についての考慮が不要となります。

超微細粒アルミニウムから微小化されたマイクロピラー
Ga FIBで加工されたピラーは粒界に沿ってGaイオンの付着が見られるのに対し、Xe FIBで加工されたピラーにはすべり線が確認できるほど汚染がありません。
3Dイメージング
大容量3Dイメージング
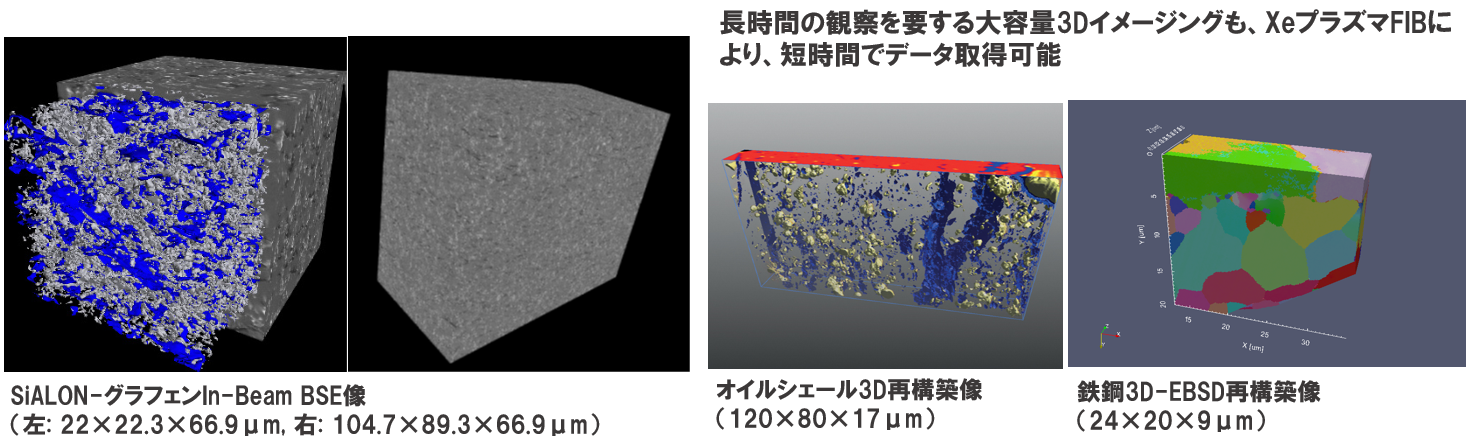
アーティファクト抑制技術
高いFIBのミリングレートは、断面加工に置いてアーティファクトの誘因となることがあります。
カーテニングとして知られるアーティファクトは、断面を出そうとしている表面の凹凸、ミリングのばらつきをもたらす化学組成の不均質、または試料中の結晶配向の相違によって発生します。
TESCAN社はプラズマFIBの特長である高いミリングレートの特性を損なうことなく、高品質の断面加工が達成できるようにするための独自技術をいくつか提供しています。その中で最も効果的な手法は、新たに開発された加工面の二次傾斜を利用する独自のRocking Stageを用いて、カーテニングを大幅に低減させることです。
加工中の断面のリアルタイムモニタリングとRocking Stage技術を併用することにより、非常にきれいな断面を保つことができます。

Rocking Stage を用いてはんだバンプの断面加工を-10°と+10の角度で交互に行った例
TOF-SIMSオプション
TOF-SIMS検出器オプションを用いたLiバッテリの分析例



