Xe プラズマ FIB-SEM
プラズマFIB-SEMが必要な理由
電子デバイスや高機能材料の開発、解析、プロセス開発において、試料の内部構造や断面構造を確認することは、重要な評価項目になっています。また不具合が発生した際、その原因を解明するためにも、断面構造の確認が必要です。
内部構造を確認するために行う断面加工には、断面研磨やアルゴンを用いたブロードイオンビームによる手法を用いるのが一般的ですが、特定部位を狙った微細な加工ができないため、複雑な構造を持つ電子デバイスや不具合原因解明には適しません。そこで、現状、試料の内部構造や断面構造を確認するために必要な特定部位の加工には、SEMにGa(ガリウム)イオンを使用した集束イオンビーム装置を搭載したFIB-SEMシステムが用いられています。しかし、加工に長時間かかり、加工範囲が数10μm領域に限定されるという課題があります。試料の内部・断面構造の確認では100μmを超える範囲を加工したいというニーズも多数ありますが、何日も時間をかけて加工を行うか、加工自体を断念するケースが多く見られます。
プラズマFIB-SEMシステムは、現行のGaイオンFIB-SEMシステムに比べ50倍以上のビーム電流量を持つことから、高速かつ広範囲・大面積の加工ができ、また、数10nmレベルの位置精度で狙った箇所の微細加工が容易にできます。従来、数日かけて行っていた加工や断念していたmm領域の断面加工が1日の内に実施できます。これにより、出来栄え確認や不具合原因調査が迅速・確実に実施できるようになり、開発効率の向上・スピードアップ、不具合原因の究明による品質向上、製造過程の歩留まり改善に寄与します。
FIB-SEMとは
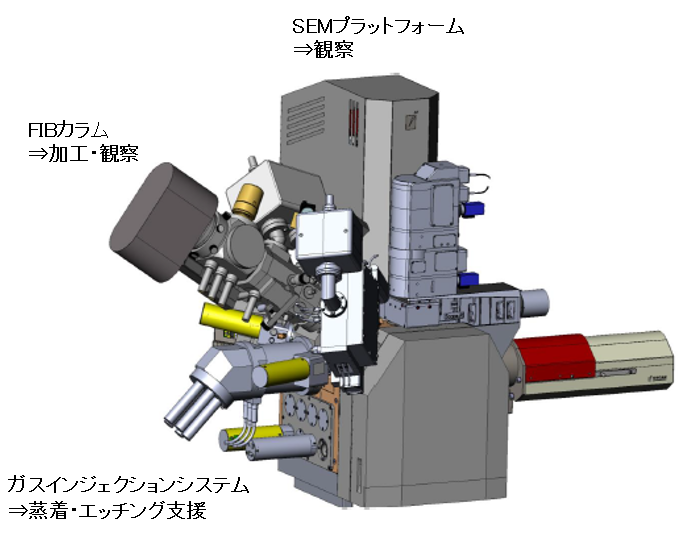
FIB-SEM(Focused Ion Beam Scanning Electron Microscopes)は、高分解能観察が可能なSEM鏡筒と、微小領域の断面加工が可能なFIB鏡筒を組み合わせた複合機を指します。SEMカラムやFIBカラムなどの配置は各社様々です。

サンプル表面がFIBカラムに垂直になるように傾斜して加工を行います。その加工面を、SEMカラムを用いて断面を観察することが可能です。加工中のリアルタイムSEM観察も可能です。
SEMやFIB以外にも、デポジション膜や選択エッジング用のガスインジェクションなど、様々なオプションを搭載することが一般的です。TEM観察用薄片試料の作製、EDSやEBSDなどと組み合わせた3Dイメージングにも用いられています。
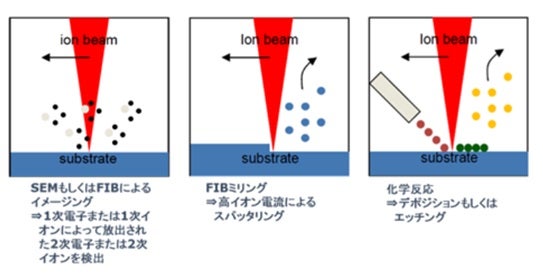
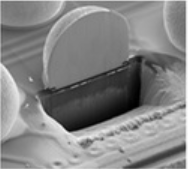
断面観察
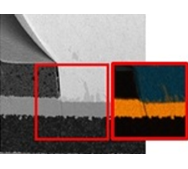
故障解析

TEM試料作製

3Dイメージング

3D EBSD
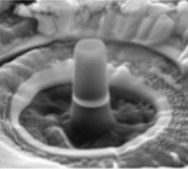
機械特性評価用ピラー作製
- 検索結果が見つかりませんでした