ナノインデンテーションを用いたLow-k薄膜のヤング率と硬度の測定
このページでは半導体で用いられるLow-k薄膜(低誘電率膜、層間絶縁膜)のヤング率を取得した例を紹介しています。Low-kのヤング率は誘電率とも密接に関連しており、ナノインデンテーション法を用いて膜のヤング率を求めるということは日本でも過去から盛んに測定されてきました。なお、本稿ではヤング率の算出において、基板の影響を取り除く手法も用いております。
[概要]この研究では、ナノインデンテーションを使用して、シリコン上の2つの名目上同様の低誘電率(low-k)膜の機械的特性を測定しました。膜厚は196 nmと478 nmです。iNanoナノイデンターは自動的にシリコン基板の影響を考慮して、薄膜のみの特性を測定します。 196nm厚の薄膜では、ヤング率E=6.48±0.27、硬度H=1.22±0.06(N=10)と測定されました。478nm厚の薄膜では、E=6.14±0.14、H=1.17±0.03(N=10)と測定されました。2つの薄膜を比較すると、EとHの差はわずかでしたが、統計的には有意差があります(ρ<0.05)。より薄い薄膜の方が強度も大きいという結果は、より微細な構造(小さい体積の方が拘束が大きい)ということによって引き起こされるによるものでした。
[はじめに]ナノインデンテーションを使用すると、ヤング率や薄膜の硬さやその他の微小なの材料の硬度を測定できます。これまでのところ、ナノインデンテーションの最も一般的な用途は、マイクロエレクトロニクス用の低誘電率(low-k)膜の機械的特性評価です。マイクロエレクトロニクスチップでは、導電線はlow-k材料によって電気的にも機械的にも分離されています。 最適な電気的分離のためには、誘電率kは可能な限り低くあるべきです。 しかしながら、フィルムの多孔度を増加させるなど誘電率を低下させる傾向があるプロセスは、同時に材料の強度を低下させる傾向があります。したがって、マイクロエレクトロニクス設計における重要な最適化は、十分な機械的強度を維持しながら誘電率をできるだけ低くすることです。ナノインデンテーションは、低誘電率材料の機械的強度を評価するための主要な手段です。
ナノインデンテーション測定を行うために、low-k膜は通常シリコンウエハ上に堆積されます。そのような薄膜を試験するとき、基本的なナノインデンテーション試験では支持シリコン基板によって、測定値が影響を受ける可能性があります。その結果、Oliver-Pharr法のみで測定されたヤング率[1]は、押し込みの深さが膜厚のほんの一部にすぎない場合でも、実際より大きな値として得られてしまう場合があります。iNanoナノイデンター(インデンテーションシステム)には、基板の影響に対する自動補正が含まれています。測定されたヤング率は、成膜された基板とは無関係に、low-k膜の真の値となります[2]。フィルムの真のヤング率Efは、補正されていないまたは「見かけの」ヤング率(Ea)、押込み深さ(h)、フィルムの厚さ(tf)、基板のヤング率(Es)、基板のポアソン比(νs)の関数として計算されます:
右辺の全てのパラメータは薄膜材料ではよく知られている場合が多いです。iNanoナノイデンターでは標準機能として押し込み中に微小振動を加えることで、硬度・ヤング率の深さプロファイルを取得する機能(連続剛性測定法)を備えています。この機能を用いない場合(ISO法)は最大荷重における深さ1点のみでしか硬度・ヤング率が求まりません[1]。薄膜のサンプルを試験する上で、硬度・ヤング率の深さプロファイルが取得できるというのは途轍もなく有用です。というのも、補正の前後でどのようにデータが変化し、その基板の影響がどのようなものであったか直感的に捉えることができるからです。基板の影響が正しく補正されている場合、測定された特性は深さに対して一定になるべきです。
[サンプルと測定手法]SBA Materials, Inc.から提供していただいた2種類のLow-k材料を測定しました。SBA Materialsは先進電子材料の大手サプライヤーです。
表1 low-kサンプルの物理特性(SBA Materialsが測定)| サンプル名 | 膜厚(nm) | 屈折率n注1 | 誘電率κ注2 |
|---|---|---|---|
| A | 196.27 | 1.285 | 2.215 |
| F | 477.51 | 1.283 | 2.169 |
注2) 1MHzで測定
これらの材料のヤング率を測定するため、iNanoナノイデンターを使用しました。また、圧子は最も一般的に使用されるバーコビッチを用いました。各サンプルに対し室温で10点の押し込み試験を行い、その際には “Dynamic CSR for Thin Films”というメソッド(手法)を用いました。このメソッドは下記の手順で各試験点において自動的に行われます。
- 圧子をサンプル表面に対し、30nm/秒の速度で近接させてサンプル表面に接触させます。
- 圧子をひずみ速度0.2/秒で押し込んでいきます。その際、振幅1nm、周波数100Hzの振動を重畳させます。
- 膜厚の50%の深さになったところで荷重の増加をストップします。この荷重を1秒間保持します。
- 最大荷重の10%になるまで10秒以上かけて除荷します。
- 最大荷重の10%の荷重で80秒間保持します。荷重を保持している間、変位レートは理想的には0ですが、実際には熱ドリフトの影響で0にはならず、結果としてドリフトレートが得られます。
- 圧子をサンプル上方に退避させ、次の測定点へ移動します。
Hay-Crawfordモデルを用いて薄膜の特性を正確に求めるためには、膜厚に加えて基板のヤング率を知っておく必要があります。表2に各薄膜の機械特性を計算するために入力した解析パラメータをまとめています。
表2 解析パラメータのまとめ| ドリフト補正 | 有効 |
|---|---|
| 膜厚 | 196nm / 478nm |
| 基板のポアソン比 | 0.2 |
| 基板のヤング率 | 170GPa |
| 薄膜のポアソン比 | 0.3 |
| 薄膜のヤング率計算範囲 | 膜厚の29%~31% |
| サンプルの形態 | 薄膜 |
[結果と考察]
荷重印加中に加えられる振動(1 nm、100 Hz)により、圧子が材料に押し込まれるにつれて、連続的な接触剛性が測定されます。 図2では、薄い色のプロファイル(ピンクと水色)は動的剛性測定にOliver-Pharr法を適用することによって達成されたヤング率を示しています。x軸は、フィルムの厚さで正規化された押込み深さです。例えば0.5は膜厚の半分の深さを意味します。押込み深さが膜厚のごく一部である場合、ヤング率は比較的低いですが、押込み深さが増加するにつれて非常に硬いシリコン基板(E=170GPa)の影響が増大するため、測定されたヤング率も増加します。これらの値は実際には基板の影響を受けていますが、次の説明に繋がる価値ある最初のステップです。
図2の赤と青の線はHay-Crawfordモデルによって基板の影響を取り除いたものです。これは正規化された深さに対してほぼ一定となっており、モデルの正確性を表しています。赤と青のプロファイルはピンクやライトブルーのプロファイルと同じ試験ですが、基板の影響が補正されています。各プロファイルの全てのデータを膜厚の29%~31%の間の範囲(図2内の黒い実線の間で示された区間)で平均して各サンプルのヤング率を算出します。これを測定点10点で平均して、サンプルごとのヤング率の平均値と標準偏差を求めるとサンプルAについてはEf = 6.48±0.27、サンプルFについてはEf = 6.14±0.14という値が求まります。
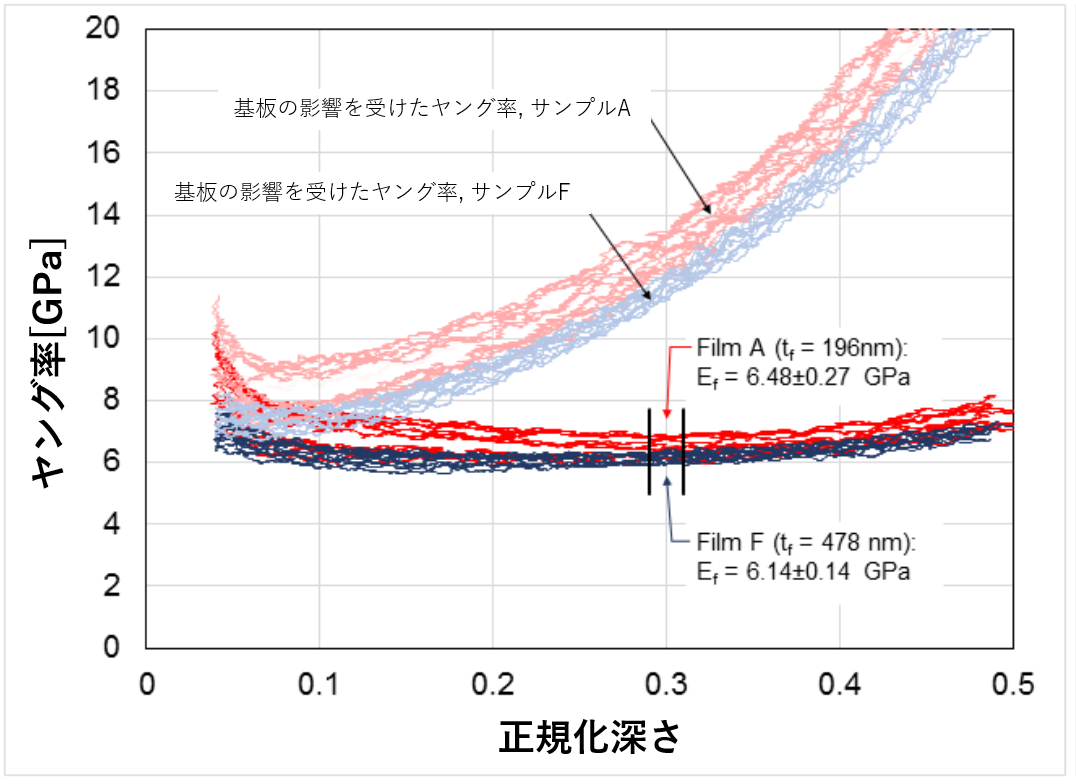
図2 膜厚で正規化された、押し込み深さの関数としてのヤング率。
ピンク色のプロファイルはそれぞれフィルムAの個別試験データを表し、ライトブルーのプロファイルはそれぞれフィルムFの個別試験データを表します。赤と青のプロファイルはそれぞれ同じ試験のデータですが、基材の影響についてのみ補正されています。修正されたプロファイルを使用して、フィルムのヤング率はフィルムの厚さの約30%で計算しました。
ナノインデンテーションの分野では、フィルム厚の10%未満の押し込み深さでの評価であれば実質的に基板の影響を受けないと仮定することが一般的なやり方です。しかし、low-k材料の場合、基板がフィルムよりもはるかに硬いため、このような仮定は大きな誤差を引き起こします。 実際、フィルム厚さの10%における図2の薄い色のプロファイル(補正前のプロファイル)から計算されるモジュラスの値は、フィルムAについてはEa = 8.49GPaですが、フィルムFについてはEa = 7.43GPaです。サンプルAの値は30%過大評価され、サンプルFの値は20%過大評価されます。これらの盛られた値に基づくビジネス上の決定は製造業者にとって壊滅的なものになるかもしれません。
Hay-Crawfordモデルは、基板の影響が懸念されるサンプルを測定する場合に、より大きな深さでの試験でも薄膜の評価が可能となります。簡単に言えば、ユーザーは20nmよりも50nmで正確で再現性のある測定値が得られる可能性の方がはるかに高いです。押し込み深さが減少するにつれて、より困難な実験を余儀なくされます。そのような困難には、表面粗さ、圧子先端の欠陥、表面検出、および振動ノイズ(設置環境)が含まれます。Hay-Crawfordモデルでは、膜厚の40%の大きさの押込み深さを使用しても、基板の影響のないヤング率測定を行うことができます。
塑性変形の領域は弾性変形の領域よりもはるかに小さいので、硬度は基板の影響を受けにくいです。図3は、Oliver-Pharr法のみで測定した硬度を示しています。薄膜がシリコン基板よりはるかに柔らかいにもかかわらず、硬度プロファイルは正規化された深さではほとんど増加しません。したがって、硬度に対する基材の影響を説明するのに補正は不要です。各プロファイルの全てのデータを膜厚の29%~31%の間の範囲(黒い実線の間)で平均して各サンプルの硬度を算出します。最後に、これらの個々の値の平均および標準偏差を10回の押し込み試験すべてにわたって計算して、サンプルAについてH=1.22±0.06、およびサンプルFについてH=1.17±0.03という値を得ることができます(興味深いことに、フィルム厚の40%において、プロファイルはほぼ同一の値に収束しています)。
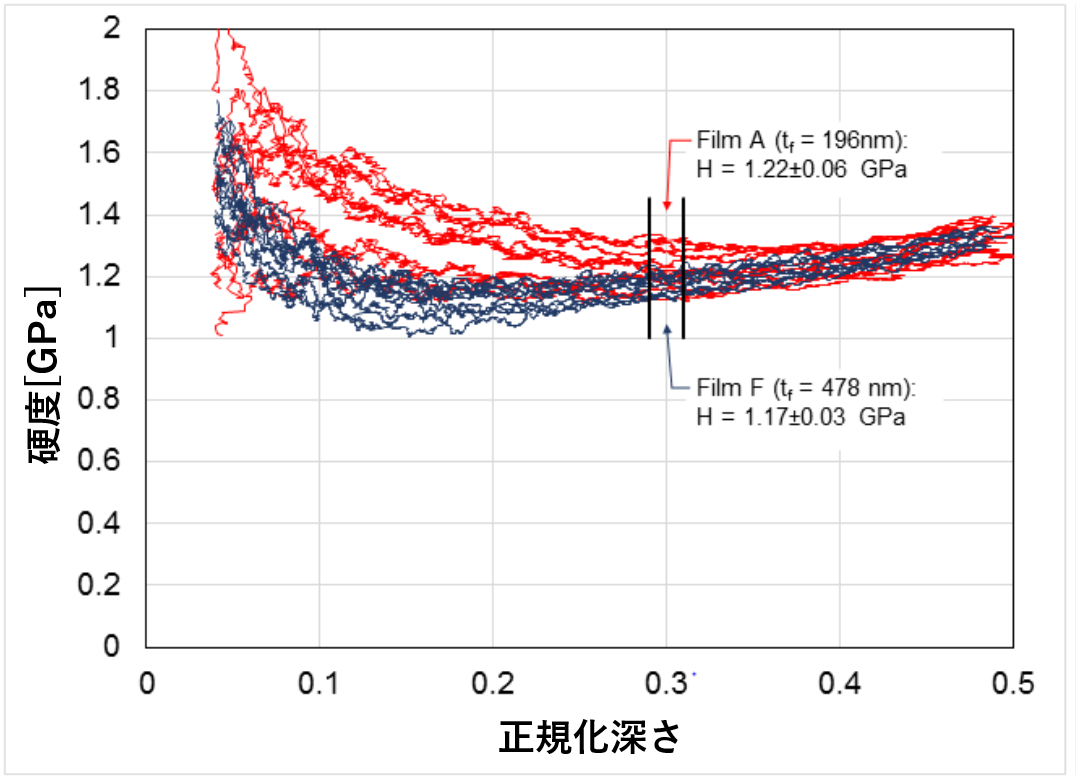
図3 薄膜の厚さで正規化された、押し込み深さの関数としての硬度。
それぞれの赤のプロファイルはサンプルAの個別試験データを表し、それぞれの青のプロファイルはサンプルFの個別試験データを表します。硬度は基材の影響を比較的受けにくいため、修正モデルは不要です。元のプロファイルを使用して、硬度は膜厚の約30%の深さで計算しました。
表3は、両方のサンプルのすべての試験結果をまとめたものです。 2つのサンプル間のEとHの差は小さいですが、統計的に有意です(p <0.05)。より薄いサンプルAの方が、ヤング率および硬度が若干高いという結果になりました。これらの薄膜は同じ特性になるように設計されていましが、サンプルAについてのより小さい体積による制約は微細構造に影響を及ぼし、そしてこの効果は機械的性質において明らかな違いを生んでいます。この結論の確からしさは、2つの材料の誘電率の測定結果にわずかに差があることでも裏付けられます。より厚いサンプルFは誘電率がわずかに低いという結果が出ており、Fの方がわずかに低いヤング率になるという結果になっても驚くことではありません。なぜなら、誘電率を低下させる傾向があるプロセスはヤング率をも低下させる傾向があるからです。
表3. iNanoナノイデンターで測定された薄膜の機械的特性のまとめ
| サンプル名 | 測定点数 | 計算深さ範囲 | Ef (GPa) | H (GPa) |
|---|---|---|---|---|
| A | 10 | 56.8~60.8 | 6.48±0.27 | 1.22±0.06 |
| F | 10 | 138.6~148.2 | 6.14±0.14 | 1.17±0.03 |
[結論]
体積が微細構造に影響を与えそれが次に機械的特性に影響を与えるため、ナノインデンテーションはそれらを評価できる貴重な測定ツールです。材料の機械的性質は、それらが存在することを余儀なくされる量にしばしば依存します。iNanoナノイデンターは、最先端のハードウェア、電子機器、試験手順および分析手法を採用しており、非常に薄い薄膜に対しても正確で再現性よく特性を評価することが可能です。この記事では、名目上類似している2つの低誘電率膜を比較したところ、薄い膜ほどヤング率がわずかに大きいことがわかりました。この発見は、他の市販のナノインデンテーションシステム、特に薄膜モデリングや動的荷重を重畳した押し込みの機能を備え得ていないシステムを用いている場合には正しい評価にたどり着いていない可能性を示唆しています。
[参考文献]
1. Oliver, W.C. and Pharr, G.M., “An Improved Technique for Determining Hardness and Elastic Modulus Using Load and Displacement Sensing Indentation Experiments, Journal of Materials Research 7(6):1564-1583 (1992).
2. Hay, J.L. and Crawford, B., “Measuring Substrate-Independent Modulus of Thin Films, Journal of Materials Research 26(6):727-738 (2011).

