走査電子顕微鏡(SEM: Scanning Electron Microscope)の原理
みなさんの「目」の分解能は0.1mm程度といわれています。顕微鏡の中で最も身近な「光学顕微鏡」の分解能は0.2um程度です。光学顕微鏡によって、人間をはじめとする生物の体が細胞の集まりであることが明らかになりました。しかし、我々の健康を脅かすインフルエンザウィルスは100nm程度の大きさなので、光学顕微鏡では見えません。そのウィルスの存在を明らかにしたのが「電子顕微鏡」です。今や電子顕微鏡は生命科学だけでなく、半導体故障解析や先端材料開発などに欠かすことができません。ここでは「電子顕微鏡」の中で最も汎用的な「走査電子顕微鏡」の原理を紹介します。
1. 表面を見るためには刺激が必要
表面を見るということは、表面に何らかの刺激を与えて、その応答を観測するということです。試料表面に光を当て、反射(透過)した光の強度から表面形状を観察するのが光学顕微鏡です。可視光に限らず、赤外線や紫外線、X線など様々なエネルギーの電磁波(光)を試料に当てると、構成原子・分子と相互作用し、その応答からより多くの情報が得られます。例えば赤外分光に用いる赤外線は、分子の伸縮や回転を引き起こすため、その応答から分子構造がわかります。X線光電子分光(XPS)などに用いるX線はエネルギーが高いため、最も安定した内殻電子までも弾き飛ばします。この応答から原子種の同定などに用います。イオンを試料にぶつけて、はじき出された原子・分子の質量数を調べるのが二次イオン質量分析(SIMS)、鋭く尖った針を試料表面に近づけて、その応答から表面形状を探る走査型プローブ顕微鏡(SPM)です。一方、電子を当てて、試料を透過した電子を観察するのが透過電子顕微鏡(TEM)、反射した電子を観察するのが走査電子顕微鏡(SEM)というわけです。
2. 顕微鏡の分解能は何で決まる?
分解能とは、「近接する2点を2点として識別できる最小距離」で表します。
光学顕微鏡ではレンズを用いて拡大・結像しますが、光は波の性質を持つため、回折という現象によって、無限に小さい点光源さえもレンズや絞りの縁で光が曲がり、同心円状の拡がりをもって結像されます。(図1 参照)この拡がりは0.61×(光の波長)÷(レンズの開口数)で定義されます。油浸レンズなどの特殊なレンズを用いれば開口数は1.2程度まで上げられますので、分解能はおよそ光の波長の半分程度、つまり数百nmに制限されるということになります。

図1:光の回折による像のぼやけ
電子顕微鏡の場合、電子線の波長はエネルギーで決まります。例えば15kVで加速された電子線の波長は約0.01nmです。つまり理論上、加速電圧を上げればいくらでも分解能は上げられるということです。しかし100万V以上の最先端超高電圧電子顕微鏡をもってしても0.1nm程度が限界です。それはなぜでしょうか?次からその原因について見ていきましょう。
3. SEMの分解能は何で決まる? ~その① 電子源~
電子銃は、光学顕微鏡における光源に相当します。電子銃は主に熱電子放出型と電界放出型に分けられます。熱電子放出型は、タングステンフィラメントやLaB6単結晶チップに電流を流して2000K以上まで加熱した際に発生する熱電子を電子源に用います。電子ビーム径は数十um程度です。一方、電界放出型は先鋭化したタングステン単結晶チップ表面に10V/nm程度の高電界を加えて電子を引き出します。その際に1800K程度に加熱した上で高電界を印可する方式を「ショットキータイプ」、室温のまま方式を「コールドタイプ」と呼びます。電子ビーム径は数十nm以下で、こちらを採用しているSEMをFESEMと呼んで区別します。FE-SEMの方が、電子源の大きさだけでなくエネルギー幅や輝度、干渉性などの面で優れていますが、安定動作を得るためには10-8~10-9Paの超高真空環境が必要です。熱電子放出型は、試料が帯電しにくく水分や油分を含むものでも測れる低真空SEMや廉価版SEMで主に採用されています。
4. SEMの分解能は何で決まる? ~その② 電子レンズ~
光学顕微鏡では光を曲げるためにレンズが必要ですが、SEMにも当然レンズが必要です。とはいってもガラスのレンズではなく、電子レンズと呼ばれるコイルや電極を用います。これらで電磁場を発生させ、電子線の軌道を曲げます。(図2参照)
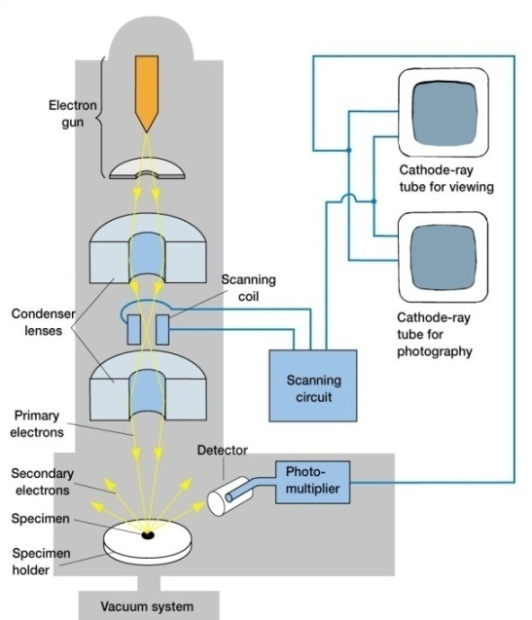
図2:一般的なSEMの構造
しかし、2項で述べた光学顕微鏡の「回折」のように、電子レンズでも例外なく結像の際にボケを生じさせる要因が多く存在します。これらをまとめて「収差」といいます。以下に主な収差について説明します。
| 回折収差 | 図1 参照。SEMでは電子線の波長を短く(高加速電圧化)するか、開口数(電子線の開き半角)を大きくすることで抑えられます。 |
|---|---|
| 球面収差 | レンズに入射する電子線のうち、レンズ周辺部を通る電子線は理想的な焦点位置からのずれが大きくなり、像のボケや歪みが生じます。これは凸レンズ特有の収 差で、光学顕微鏡では凹レンズを組み合わせることで除去していますが、電子レンズで主に用いられている磁場レンズでは、原理上凸レンズ作用しか得られず、 複雑な磁界を形成するための多極子磁場レンズを用いて補正しています。この球面収差補正技術はまだ発展途上で、現在電子顕微鏡メーカ各社でしのぎを削って います。 |
| 色収差 | 電子線のエネルギー(波長)のばらつきによって屈折率が異なるため、像がぼやけます。加速電圧を高めたり、エネルギーのばらつきが小さいFE-SEMを用いることで改善します。 |
| 非点収差 | レンズ材質の不均一性や加工精度が原因で起こる収差で、非点補正装置(スティグマ)を用いることで改善できます。 |
5. 電子を当てるといろいろなものが飛び出してくる
電子を試料に入射すると、そのまま素通りするもの、電子と衝突してエネルギーを変えずに進路を変えるもの(弾性散乱)や、一部のエネルギーを失うもの(非弾性散乱)など、様々です。その中で、エネルギーを失い50eV 以下のエネルギーで飛び出した電子を「二次電子」と呼びます。
そのため、試料表面から約10nm以内の深さで発生したものしか真空中に脱出できません。その結果表面敏感になります。二次電子は入射角に対し傾いている領域や、突起、エッジ部で試料表面から脱出しやすくなるため明るく光り、立体的な像が得られます。また、加速電圧が高いほど深い領域からの情報が影響して像がぼやけ、軽元素材料も見えにくくなります。一般的にはSEM像は二次電子像のことを指します。弾性及び非弾性散乱電子の中で、後方に散乱したものを「反射電子」と呼びます。
反射電子はおよそ数十~ 100nm 程度の領域から発生し、試料の原子番号が大きくなるほど、信号強度が増加する性質から、元素の違いを推測するのに用います。
非弾性散乱の場合、電子がはじき出されて空準位が発生し、その緩和過程で電子(オージェ電子)や電磁波・光(特性X線、カソードルミネッセンス)も発生します。これらは主に元素分析に用いられますが、それぞれは得られる物性情報や脱出深さなどが異なります。
6. 電子顕微鏡の応用、FIB-SEMとは
電子デバイスや高機能材料の開発、解析、プロセス開発において、試料の内部構造や断面構造を確認することは、重要な評価項目になっています。また不具合が発生した際、その原因を解明するためにも、断面構造の確認が必要です。
内部構造を確認するために行う断面加工には、断面研磨やアルゴンを用いたブロードイオンビームによる手法を用いるのが一般的ですが、特定部位を狙った微細な加工ができないため、複雑な構造を持つ電子デバイスや不具合原因解明には適しません。そこで、現状、試料の内部構造や断面構造を確認するために必要な特定部位の加工には、SEMにGaイオンを使用した集束イオンビーム装置(FIB)を搭載したGa FIB-SEMシステムが用いられています。
また近年プラズマFIBを新たに搭載したプラズマFIB-SEMシステムが登場し、現行のGaイオンFIB-SEMシステムに比べ50倍以上のビーム電流量を持つことから、高速かつ広範囲・大面積の加工を可能とし、さらには数10nmレベルの位置精度で狙った箇所の微細加工が容易にできます。